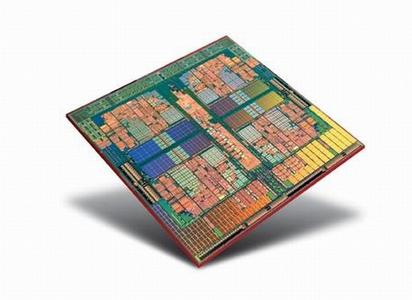
AMD首席系统架构师张铃兰近期表示AMD研发的HBM内存融合GPU计划已经得到了初步完成。
很大程度上来说,3D堆栈显存是目前最有可能造成巨大带宽飞跃的技术之一,不过这项技术还在试验阶段,毕竟没人确定他们的成本很低可以马上代替DDR5显存,但考虑到NVIDIA和AMD都在研发类似HBM的东西。可以认为该技术是未来满足4K和8K分辨率下带宽的必备武器。
关于AMD最新的斐济芯片,张玲兰表示近一年来,AMD都在测试HBM能否能采用到显卡中,为了实现这样的计划消耗了大把时间。然而斐济芯片目前采用的是2.5D分离式内存来适应显卡的需求。不过它同样可以融入SoC和APU当中。HBM确实足以为显卡带来TB级别的恐怖带宽,甚至还可以帮助SoC和APU这样依赖带宽的统一寻址处理器提供质变的飞跃。只是目前功耗和成本让我们非常失望,目前斐济芯片满载300W的功耗超过了我们的预期,然而HBM内存的单价成本也迫使显卡报价上成为问题所在。这样的问题让我们不得不改变原有计划。
看来AMD方面尚不能采用20nm工艺进行芯片制造,否则也不会有如此之高的TDP功耗,不过根据推理来看,AMD目前仍旧可能是采用28nm HPM工艺。在当前GPU没有新工艺的情况下,看来AMD显卡业务的进展要暂时受阻。不过分析师也表示,如果仅仅采用28nm HPM工艺,那么麦克斯韦架构的GM200芯片估计功耗控制能力也不会有多好,不过他们相信肯定是低于250W TDP。
2.5D封装将会比3D更适合发热量大的显卡GPU芯片
考虑到成本和技术成熟度,AMD可能选择了2.5D封装的堆栈式内存,而不是传说中的3D。AMD官方似乎认为3D封装的成本和难度较大,同时覆盖过多面积导致散热措施缺乏。而2.5D方面则是发热量控制更好。
通过图片可以看出,2.5D封装对比3D要少占用更多区域。这样的设计方式应该说可以很节约成本的,同时更加灵活多变,对于显卡这种需要控制成本的产品来说。HBM多少还是有些压力很大,毕竟无意义的成本只会让显卡售价不占优势。2.5D可是说是AMD目前考虑的灵活多变的方式,至少哪怕是失败了还可以重新完成尝试。
不过AMD的工程师也明确表明了,AMD近期研发的斐济芯片可能搭载到390X显卡中,而斐济芯片正是代替Tahiti芯片的。AMD临时的计划可能取消了百慕大芯片的试验,反而把390X采用了斐济芯片,而原本380X及其以下产品将会命名为“King of the hill”,因为他们没有采用HBM内存,AMD只有390X会采用HBM内存,而且他目前看正是斐济芯片。
而对于百慕大芯片,AMD方面则没有任何评论。或许当今的制造工艺尚不足能满足的斐济芯片的需求,这让百慕大芯片恐怕暂时无法离开实验室。













